 1. ábra * A Twyman-Green interferométer sematikus vázlata
1. ábra * A Twyman-Green interferométer sematikus vázlata
A cikkben egy nagyfelbontású lézer-interferometrikus felületvizsgálati módszert és berendezést mutatunk be, amely a fényhullám fázisának interferometrikus detektálásával nanométer alatti transzverzális - a felületre merőleges - domborzati felbontást tesz lehetővé. Célunk - a Nanotechnológia című program keretén belül - egy olyan berendezés kifejlesztése, amely számos, csúcsparaméterekkel rendelkező új megoldást tartalmaz. A tervezett berendezés transzverzális felbontása kb. 0,1 nm, ami már az anyag mikrostrukturális paramétereivel is összemérhető (például az atomsíkok távolságával). A berendezés széleskörű alkalmazási lehetőséget nyújthat a különlegesen finom megmunkálású felületek (mikroelektronikai rétegek, memóriaegységek, optikai felületek, csörpölt lézertükrök, optikai szálak, stb.) minősítésénél, valamint számos olyan területen, ahol precíz technológiák megvalósítása a cél.
Bevezetés
Amikor James Watt 1776-ban, a birminghami üzletember Matthew Boulton megrendelésére, Wilkinson-esztergagépén megépítette az első gőzgépét (ezt New Method for Lessening the Consumption of Steam and Fuel in Fire Engines címmel szabadalmaztatta), az alkotóelemek megmunkálási pontossága alig érte el az 1 millimétert. A gőzgép hengerének átmérője 127 cm volt, teljesítménye nem haladta meg a néhány lóerőt, ennek ellenére a század végére már több mint ötszáz ilyen gép működött az angliai bányákban. A szemléletes összehasonlítás érdekében a későbbi gépeit úgy népszerűsítette, hogy ezekkel akár húsz ló munkáját is helyettesíteni lehet, ami lényeges megtakarítást jelentett (innen származik a lóerő, a teljesítmény ma is használt mértékegysége). Ha nem is olyan gyorsan, mint a mai számítástechnika, a gépgyártás és ezzel párhuzamosan a méréstechnika is fejlődött, mivel egy adott tűrésű alkatrész legyártásához legalább egy nagyságrenddel pontosabb mérésre van szükség.
A múlt század második felében az egyre pontosabb méréseket már nem csak a gépgyártás igényelte, egyre több olyan technológia fejlődött ki, ahol a geometriai méretek meghatározása és a felületek minősítése a mikronos és mikron alatti tartományba tolódott. A felületek érdességének, síkszerűségének vagy görbületének minősítésére volt szükség a jó minőségű, reprodukálható mikroelektronikai rétegek technológiájának megalapozásához, optikai szálak létrehozásához, mechatronikai alkatrészek teszteléséhez és számos olyan technológia kifejlesztéséhez, amely a tömeggyártás igényei miatt nagy tőkét mozdított meg. Ez számottevő befektetéseket tett lehetővé a kapcsolódó iparágakba - főleg a méréstechnikai kutatásokba és fejlesztésekbe. Az elterjedt tömegtermékekből csak néhányat kiragadva - például a Ferrotec Co. (Szingapúr, www.ferrotec.com.sg) által gyártott winchesterek tárolólemeze fölött (annak forgása közben) a leolvasó és író fej néhány tized mikronra van a felülettől, a Philips CD RW író-olvasó egységében is hasonló pozicionálási követelmények vannak, csakúgy, mint a DVD-író berendezésekben. Ezek után el lehet képzelni, hogy a felületek minősítési követelményei bőven a nanométeres és az alatti tartományba esnek, ami a gépészet hőskorához képest egymilliószoros változást jelet.
A felületek minősítése terén erre a pontosságra jelenleg négy, egymástól eltérő technika képes:
* Röntgensugár diffrakció (X-ray Diffraction - XRD),
* elektronmikroszkópia TEM (Transmission Electron Microscopy), SEM (Scanning Electron Microscopy),
* atomi erő mikroszkópia, ami szintén pásztázó (scanning) módszerrel működik
* lézeres interferometria (Maudgal, 1998).
A fentiek közül az általunk évtizedek óta művelt lézeres interferometria nagy előnye, hogy a gyakorlati alkalmazhatóság szempontjából a többiekhez képest jóval egyszerűbb, a minta nem igényel előkészítést (mint például az elektronmikroszkópiában), a mérés érintésmentesen történik, az adatok viszonylag nagy felületről egyszerre jelennek meg, azonnal kiértékelhetők és abszolút méretmeghatározást tesznek lehetővé, mivel a hosszmérték maga a lézerfény jól definiálható, stabilizált hullámhossza. További előnyt jelent, hogy a minta topológiája három dimenzióban közvetlenül jeleníthető meg.
A mérés elve azon alapul, hogy egy kettéosztott koherens fényhullám egyik részét a vizsgálandó felületre irányítjuk, majd az onnan visszaverődő fényt (amelynek a hullámfrontját a felület egyenetlenségei torzítják) összehasonlítjuk (összelebegtetjük, illetve interferáltatjuk) annak a másik részével (amely ideális esetben nem szenvedett változást), és a két fényhullám eredőjéből meghatározzuk az összeadott hullámfrontban a felület által okozott perturbációk mértékét. Olyan interferométert, amellyel az egyik ág geometriai elmozdulásait lehetett mérni, először Albert A. Michelson épített 1881-ben (1907-ben kapott érte Nobel-díjat), később többen építettek hasonló berendezéseket, kimondottan felületek profiljának - érdességi paramétereinek, síkszerűségének vagy görbületeinek - vizsgálatára. Az ilyen interferométerekben az interferencia során az összeadandó hullámfrontok eredményeként kialakuló intenzitásmaximumok és -minimumok közti távolság a fényhullámhossz felének felel meg (piros fény esetén ez kb. 300 nm), detektálni pedig ennek a töredékét is lehet, ezért a mérés a felület fényhullámmal történő "letapogatásához" hasonlítható, melynek során a mérőág hullámfront torzulásának mértéke hordozza a transzverzális felületi egyenetlenségekre jellemző információt. A hullámfront-torzulás mértékét különböző fázisdetektálási módszerekkel közvetlenül a fél-hullámhossz ezredrészének megfelelő felbontással is le lehet mérni, amit még tovább lehet fokozni. Mint minden nagy pontosságú mérés, ez is nagyon komoly követelményeket támaszt egy olyan mérőrendszerrel szemben, amellyel a felületek nanométer alatti vizsgálatát kívánjuk megvalósítani (a mérést befolyásoló paraméterek pontos ismerete és azok stabilitása igen lényeges). A továbbiakban, az Intézetünkben a Nemzeti Kutatás Fejlesztési Program keretén belül fejlesztett mérőrendszer működési elvét, felépítését, egyes részegységeit és az elkészült laboratóriumi mintapéldányt, valamint annak lehetőségeit mutatjuk be, felvázolva a hazai és külföldi alkalmazásokat.
A felületvizsgáló lézeres interferométer működési elve és felépítése
A lézeres felületminősítő interferométereknek több fajtája létezik, ezek közül a leginkább flexibilis kétsugaras Twyman-Green interferométer (Born - Wolf, 1965; Das, 1991; Stitch - Bass, 1985; Lapp et al., 1987) módosított, fázis-siftelt változatát ismertetjük, amelyben egy különleges jelfeldolgozási módszert alkalmaztunk. A berendezés optikai részének egyszerűsített elrendezése sematikusan az 1. ábrán látható. Itt a lézerből jövő fénysugár megfelelő nyalábformálás után kettéoszlik, egyik része egy referenciaágba, a másik a mérőágba kerül. A referenciaágban a fényhullám fázisát egy piezo-mozgató (PZT) változtatja, a mérőágban pedig a minta felülete torzítja a beeső fényhullám fázisfrontját. A sugarak újraegyesülése után egy speciális CCD kamerával figyelhető meg az interferogram, amiből kiértékelhető a fázisváltozás, abból pedig a vizsgálandó felület profilja.
Ha ebben a rendszerben minden mérést háromszor végzünk el, közben a referencia-ágban PZT-vel 0-p/2, p/2-p, p-3p/2 intervallumokban léptetve a fázist, akkor a jelet integrálva egy célszerű jelfeldolgozási módszerrel megkaphatjuk a mintafelület által okozott fázistorzulást. Ebből a fázistorzulásból kiszámolható a felület transzverzális domborzata. Fontos megemlíteni, hogy ebben az esetben a fázis csak modulo 2p-re határozható meg. Ha nagyobb a fázisváltozás, akkor ezt a szoftverrel kell korrigálni, feltételezve, hogy a fázisváltozás pontról pontra kisebb 2p-nél, mivel ez a következő interferencia csík tartományába esik. A módszer előnye, hogy érzéketlen a belépő fény intenzitás-eloszlására, az interferencia láthatóságára (a maximumok és minimumok intenzitásának különbségére), valamint a minta reflexiós tulajdonságaira. Ezenkívül a szoftver levonja a minta esetleges dőlését, korrigálja a helytelen fókuszbeállítást (gömbi eltérés). A berendezésben változtatható a laterális felbontás (és a képméret) is a mérőági optika nagyításának módosításával. Ha a referencia-ágban elhelyezett tükröt nagyon kis amplitúdóval rezgetjük, akkor a specle (a koherens sugaraknak a térbeli fluktuációk miatt fellépő lokális intenzitásváltozása) is kiküszöbölhető. Ha az interferométer karjait nem pontosan egyforma hosszúra válasszuk, akkor szükség van a lézer hullámhosszának stabilizálására.
A berendezésben alkalmazott He-Ne lézerekben (l = 632,8 nm) a hullámhosszat - Dl/l - 10-7 -10-8-as értékre lehet stabilizálni, a rövid idejű (egy mérés alatti) stabilitás ennél egy nagyságrenddel is jobb lehet. Ebből adódik, hogy a hosszmérték (hullámhossz) instabilitásából származó hiba kb. 0,006 nm. A másik hibaforrás a levegő turbulenciája által okozott törésmutató-változással kapcsolatos hullámfront-torzulás, amit nagymértékben lehet csökkenteni a légáramlás csökkentésével és több mérés eredményének átlagolásával. A mérési pontosságba beleszól még a mérőág és a referenciaág termikus változása is, amit jó hővezetésű, kis tágulási együtthatójú anyagok alkalmazásával lehet csökkenteni (Wolf, 1980; Wolf, 1994; Vikram, 1990; Thorlabs Catalog, 2003; Spindler-Hoyer Cattalog, 2002). A nanométeres és az alatti skálán történő méréseknél már nem elhanyagolhatóak a mintafelfogás közben fellépő mechanikai feszültségek sem, amit speciális mintafelfogókkal lehet csökkenteni, valamint a mérés közben fellépő vibrációk, melyeket rezgésmentes feltételek biztosításával lehet kiküszöbölni. Az interferenciakép megfigyeléséhez speciális CCD kamerát alkalmazunk, amely a szürke gradációkat 14 bites felbontással tudja regisztrálni, valamint egy általunk kifejlesztett kiértékelési módszert. Mivel az interferenciacsíkok közötti távolság 316,4 nm (l/2), a fentiekből adódó maximális felbontás 0,019 nm. A mérési eredményt azonban egyéb mérési és kiértékelési hibák is befolyásolják - ilyen például a referencia fázistolás hibája (a PZT linearitása), a parazita interferencia, a referenciafelület pontossága, a detektorzaj, ami relatíve annál nagyobb, minél kisebb az intenzitás (ezért célszerű minél nagyobb teljesítményű lézert alkalmazni), a kvantálási hiba (főleg a kis láthatóság esetén), a fotodetektor nemlinearitása és a koherens zaj. A fentieken kívül a mérés pontosságába beleszólnak még az optikai rendszer hibái - a térbeli felbontás nemlinearitása, amely a leképző rendszer apertúrájától függ, az interferométer aberrációi, a nem kívánt reflexiók, valamint a szórt fény koherens összeadása az interferométerben terjedő lézerfénnyel. Anélkül, hogy belemennénk az összes hibaforrás részletes elemzésébe, megjegyezzük, hogy a felsorolt tényezők a becsült maximális felbontást akár több nagyságrenddel le tudják rontani, de ezek nagy részét ki lehet küszöbölni, vagy legalábbis nagymértékben csökkenteni lehet. Ha ezt megvalósítjuk, akkor a kifejlesztett rendszerben a 0,1 nm alatti felbontás is elérhető.
A megvalósuló berendezés
A Nanotechnológia című NKFP projekt keretén belül kifejlesztettük az ismertetett lézeres felületvizsgáló interferométer két verzióját, amely egy fázis-siftelt Twyman-Green interferométerre épült. A berendezéssel néhány mintán vizsgálatokat is végeztünk, bizonyítva az alkalmazhatóságát a kitűzött feladatra. Az első lépésben fényforrásként egy polarizált 3 mW-os He-Ne lézert alkalmaztunk, melynek divergenciáját nyalábtágítóval csökkentettük. Az interferometrikus egység referencia ágát, amelyben egy piezo-vezérelt tükröt használtunk, összeépítettük egy blokkba az osztóprizmával és a fókuszáló optikával. Ebben a változatban a leképező optika, az analizátor és a CCD detektor egy másik blokkban helyezkedett el, és külön mintatartóban volt a vizsgálandó felület is. A lézernyaláb közvetlenül a polarizációs osztóprizmára esett, és onnan került a két ágba (2. ábra). A piezo-vezérelt referenciaág optikai úthosszát 10 nm-es léptékekben tudjuk változtatni, ami lehetővé tette a berendezés Z-irányú (transzverzális) felbontásának ellenőrzését és kalibrálását a fázis-siftelt interferogramok változásának a kiértékelésén keresztül.
Ezt a változást pontonként egy másik, kis apertúrájú lineáris detektorral is megfigyeltük, az interferogram különböző pontjain regisztrálva az intenzitást. A CCD detektorra képezett interferogramokat számítógéppel dolgoztuk fel. A kapott adatokat többféle módon értékeltük. Az X-Y irányú felbontást ismert minta-felülettel kalibráltuk, figyelembe véve a leképezés és a képmegjelenítés paramétereit. Jó minőségű sima felületeknél a Z-irányú (transzverzális) felületi változás egy csíkon belül volt, ami lehetővé tette a fázis-képpontintenzitás összefüggés direkt felhasználását. Ezzel már ebben a rendszerben is elérhető a nanométer alatti transzverzális felbontás. Szemléltetésül a 3. ábrán az interferogramok változását mutatjuk be a mintafelület egy csíkon belüli transzverzális elmozdulása esetén, zajszűrés nélkül (zajszűréssel az interferogramok minősége nagymértékben javul).
A berendezés következő változatában (4. ábra) egy frekvenciastabilizált lézert alkalmaztunk, melynek rövididejű (a mérés alatti) relatív stabilitása meghaladta a 10-8 értéket.
Az interferometrikus egység optikai alkatrészeit egy blokkba építettük össze, csökkentve az egymáshoz viszonyított mechanikai elmozdulások és vibrációk lehetőségét. Ez a berendezés, amely a 4. ábrán látható, egy nagyobb felbontású piezo-kerámiás referenciaágat tartalmaz, jobb minőségű tükrökkel és osztóprizmával. A száloptika is javítja a bejövő nyalábminőséget, ami jobb nyalábformálást tesz lehetővé.
A zajszűrést első lépésben a referencia ág modulálásával végezzük. Az interferogramokat a referenciaág pozíciójának egy csíkon belüli eltolásával vettük fel - így differenciális jelfeldolgozással lehetővé vált az optikai alkatrészek fázisfront-torzításának bizonyos mértékű csökkentése (Gaál et al., 1993; Czitrovszky et al., 1987; Jani et al., 1990; Jani et al., 2000). Az interferogramok különböző kiértékelésének összehasonlítása, valamint az interferencia-csíkrendszer dinamikájának a tanulmányozása különböző mintafelületek esetén elősegítette a kiértékelő szoftver algoritmusának kifejlesztését. Egy jellegzetes, egy csíkon belül torzult felület interferogramját az 5. ábra szemlélteti.
Jelenleg az új eszközök beszerzésével, az elektronikai és optomechanikai rendszer átépítésével párhuzamosan végezzük a berendezés következő verziójának kifejlesztését, amely sok szempontból felülmúlja az eddigieket. Ezzel együtt folytatjuk az adatfeldolgozó és kiértékelő szoftver fejlesztését, és annak adaptálását a mérési feladatokhoz.
Alkalmazási lehetőségek
A kifejlesztett berendezés mindenfajta szilárd felület vagy réteg háromdimenziós topológiájának vagy profiljának nagyfelbontású vizsgálatára alkalmas, ahol nanométeres vagy az alatti felbontásra van szükség. Ilyen feladat igen sok van, nemcsak a már említett esetekben (szerszámgépgyártás, mikroelektronika, száloptikák gyártástechnológiája, mechatronika, stb.), de az optikai technológia, a tribológia vagy más kutatási területen is. Hozzánk például a jó minőségű lézertükrök vagy más optikai vékonyrétegek minősítése, illetve a precíziós optikai elemek tesztelése áll közel. A felületek topológiájának és textúrájának jellemzése több paraméterrel történik, ezek közül az elterjedtebbek az Ra és Rz - amelyek az átlagos és a maximális felületi egyenetlenségeket jellemzik (a felületre merőlegesen), valamint a felületi síkszerűséget, hullámosságot és különböző görbületeket jellemző paraméterek. A feldolgozás módjától függően a kapott adathalmazból ezek mind kiszámolhatók, mi azonban egyelőre az Ra és Rz paraméterekkel foglalkozunk. Ezek kiértékelésére egy speciális szoftvert dolgoztunk ki, amely különböző módon jelenítheti meg az eredményt. Példaképpen a 6. ábrán az MTA Szilárdtestfizikai és Optikai Kutatóintézet Lézeralkalmazási Osztályának vékonyréteg laboratóriumában szuperpolírozott kvarchordozóra készült jó minőségű lézertükör felületének háromdimenziós topológiáját mutatjuk be. Ez a lézertükör egy BALZARS berendezésben elektronsugaras párologtatással készült. Mint látható, a felületnek 1 nm-en belüli Ra átlagos érdessége van.
Köszönetnyilvánítás
A berendezés fejlesztői köszönetet mondanak az NKFP 3/064/2001 számú Nanotechnológia című projekt támogatásáért, ami lehetővé tette az ismertetett berendezés létrehozását.
Kulcsszavak: interferometria, fázisdetektálás, felületi topológia nanoméretekben, képfeldolgozás, interferogram
 1. ábra * A Twyman-Green interferométer sematikus vázlata
1. ábra * A Twyman-Green interferométer sematikus vázlata
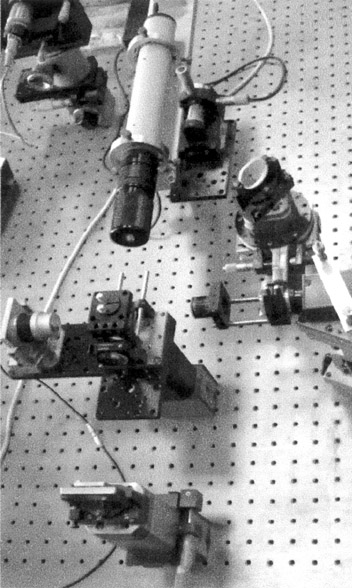 2. ábra * A nagyfelbontású felületvizsgáló berendezés első változata polarizált
He-Ne lézerre épülő változata
2. ábra * A nagyfelbontású felületvizsgáló berendezés első változata polarizált
He-Ne lézerre épülő változata
 3. ábra * Az interferogramok változása a referencia ág piezo-mozgatóval
történő egy csíkon belüli elmozdítása esetén, specle-szűrés nélkül
3. ábra * Az interferogramok változása a referencia ág piezo-mozgatóval
történő egy csíkon belüli elmozdítása esetén, specle-szűrés nélkül
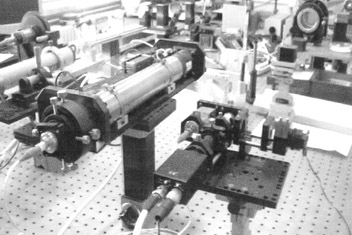 4. ábra * A lézeres interferometrikus felületvizsgáló berendezés. A
stabilizált lézer sugara szál-optikán keresztül csatlakozik a mérőegységhez
4. ábra * A lézeres interferometrikus felületvizsgáló berendezés. A
stabilizált lézer sugara szál-optikán keresztül csatlakozik a mérőegységhez
 5. ábra * Egy csíkon belül torzult felület interferogramja
5. ábra * Egy csíkon belül torzult felület interferogramja
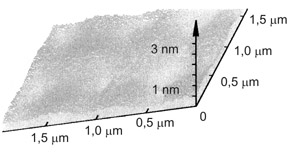 6. ábra * Egy általunk gyártott lézertükör felületének 3D-s topológiája. A
fenti berendezéssel több más, hasonló jellegű felületi érdességű optikai
réteget is vizsgáltunk.
6. ábra * Egy általunk gyártott lézertükör felületének 3D-s topológiája. A
fenti berendezéssel több más, hasonló jellegű felületi érdességű optikai
réteget is vizsgáltunk.
Irodalom
Born, Max - Wolf, Emil (1965): Principles of Optics. Pergamon Press, Oxford
Czitrovszky Aladár - Jani P. - Juhász P. - Vértes Á. (1987): Measurement Facilities on a Laser Ionization Mass Spectrometer. SPIE. 881, 103-107.
Das, Pankaj K. (1991): Lasers and Optical Engineering. Springer Verlag, New York
Dixon, Timothy H. (ed.) (1995): Interferometry and Surface Change Detection. Report of a Workshop Held in Boulder, Colorado: February 3-4, 1994.
Eom, TaeBong - Choi, T. - Lee, K. - Choi, H. - Lee, S. (2002): A Simple Method for the Compensation of the Nonlinearity in the Heterodyne Interferometers. Measurement Science and Technology. 13, 2, 222-225.
Gaál Péter - Jani Péter - Czitrovszky Aladár (1993): Proposed Data Aquisition Technique for Heterodyne Interferometers. Optical Engineering. 32, 10, 2574-2577.
Jani Péter - Czitrovszky Aladár - Szótér L. (1990): Measurement Facilites and Accuracy Limits of Sampling Digital Interferometers, Proc. of IMECO Symp. on Measurement and Inspection in Industry. Preprint KFKI-1990-38/E. 33-40.
Jani Péter - Nagy A. - Lipp Z. - Czitrovszky A. (2000): Velosizer - A Photoncorrelation System. Journal of Aerosol Science. 31, 390-391.
Jani Péter (1986): Interferometry Applieded to Ceramics. Material Chemistry and Physics. 15, 333-346.
Lapp, Marshall - Stwalley, William C. - Kenney-Wallace, Geraldine A. (ed.) (1987): Advances in Laser Science-II. American Institute of Physics. Conference proceedings No. 160, New York
Lapp, Marshall - Stwalley, William C. - Kenney-Wallace, Geraldine A. (eds.) (1996): Advances in Laser Science, vol. II, part VII, Laser Diagnostics. American Institute of Physics, Conference Proceedings No 160, Seattle, WA.
Lawall John - Kassler Ernest (2000): Michelson Interferometry with 10 pm Accuracy. Review of Scientific Instruments. 71, 2669-2676.
Maudgal, Shubha - Sims, G. D. - Johnstone, J. E - Jennett, N.M. (1998): Characterisation of Surface Roughness. National Physical Laboratory, The UK's National Measurement Laboratory - Measurement note, May, 1998.
Spindler-Hoyer Cattalog. 2002
Stitch, M. L. - Bass, M. (ed.) (1985): Laser Handbook. North Holland, Amsterdam
Sutton Christopher M. (1987): Nonlinearity in the Length Measurement Using Heterodyne Laser Michelson Interferometry. Journal of Physics E: Scientific Instruments. 20, 1290-1292.
Thorlabs Catalog on Optics, Electronics, Lasers and Fiber Optics. 2003.
Vikram, Chandra S. (ed.) (1990): Holographic Particle Diagnostic. SPIE Milestone Series. Vol. MS 21.
Wolf, Emil (ed.) (1980): Progress in Optics. vol. XVIII. North Holland, Amsterdam
Wolf, Emil (ed.) (1994): Progress in Optics. vol. XXXIII. Elsevier
Wu, Chien-ming - Lawall, John - Deslattes, Richard D. (1999): Heterodyne Interferometer with Subharmonic Periodic Nonlinearity. Applied Optics. 38, 4089-4094.